
Использование FE-8500 SEM для инспекции полупроводников
Прогресс полупроводниковых приборов резко ускорился к высокой степени интеграции, высокой интенсивности и высокой функциональности. Кроме того, использование приложений широко проникло в бытовые и промышленные сферы. Анализ отказа представляет собой процесс исследования полупроводниковых приборов после аварии электрическими измерениями, а также с помощью микроскопии и химического анализа. Это необходимо для подтверждения произошедшего отказа и выяснения отказавшего механизма. Данный процесс основывается на сборе информации о вышедших из строя механизмах для последующего установления причины или причин сбоя с помощью широкого спектра методов. Методы НК (неразрушающий контроль) обладают неоценимыми достоинствами, т.к. никоим образом не воздействуют на отказавший механизм. Поэтому, инспекция обычно начинается с применения данных методов. 5-е издание Microelectronics Failure Analysis Desk Reference, опубликованное ASM International, является отличным источником информации, охватывающем множество методов, используемых в анализе отказа полупроводников.
Типичный анализ включает, но не ограничивается следующим:
Изображения: Оптические, Тепловые, FE-SEM (в том числе ЭЦП), АСМ ( в том числе производные режимы, исследование проводящих поверхностей при помощи АСМ, электро-силовая микроскопия, бесконтактный режим АСМ, SCM( разновидность СЗМ), сканирующая микроволновая микроскопия и другие), а также изображения устройства, находящегося на пластине, полученные при помощи FE-AES.
Поверхность: сбор информации при помощи FE-AES, отображение по x y координатам, параметры глубины и состав.
Химический анализ: FT-IR микроспектроскопический анализ, анализ EDC, основанный на результатах СЭМ.
Структурный анализ: FE-SEM и TEM срез, X-Ray съемка.
Электрические характеристики - кривые I / V и параметрический анализ
Соотношение визуальных образов с операционной функцией
Соотношение химического состава и электронных данных с операционной функцией
Соотношение внутренней структуры с дизайном, разработкой, производством и эксплуатацией.
Из множества научных инструментов, используемых для описания сбоев полупроводниковых приборов, СЭМ является одним из наиболее распространенных. В связи с повсеместной необходимостью использования изображений, полученных при помощи СЭМ, в анализе отказов, новое поколение устройств, таких как компактный или настольный СЭМ, будет в центре внимания. Эти небольшие СЭМ не заменят полный набор аналитических возможностей полноразмерных устройств, однако их простота в использовании и возможность быстрого получения изображений с высоким разрешением дает возможность пользователям расширить диапазон применения СЭМ. Компактный СЭМ повышает общую эффективность и снижает время анализа, что позволяет исследователям быстро получать изображения прибора,в случае, когда для проведения дальнейшего анализа необходимы только изображения, что, в свою очередь, позволит высококвалифицированным операторам полноразмерных SEM сосредоточиться на более сложных анализах.
В компактном полевом эмиссионном сканирующем электронном микроскопе низкого напряжения Agilent 8500 применяется совершенно новый формат электростатических линз. Эта инновационная конструкция позволяет получать изображения полупроводниковых приборов с высоким разрешением, которые обычно доступны лишь при покрытии их металлом. FE-SEM 8500 используется для получения изображений вскрытого корпуса микросхемы, дефектов транзисторов, 45 нм структур ОЗ транзисторов, контактных площадок BGA (корпусов поверхностно-монтируемых интегральных микросхем)
Исследование вскрытой микросхемы
После НК анализа, следующим шагом обычно является вскрытие микросхемы. Целью вскрытия является возможность осмотра поверхности микросхемы без нанесения повреждений кремниевой подложке, проводке и выводам. Далее производятся наблюдения и измерения. Поверхность микросхемы устройства может быть обследована с помощью компактного FE-SEM (Изображения 1-5). Состояние чипов, прикрепленных кристаллов, проводки и выводов тщательно осматривается. Нарушениями, выявленными в ходе внутреннего осмотра, обычно являются: присутствие инородных тел, структурные нарушения, обрывы проводки, короткие замыкания, коррозия AI проводов, а также трещины на пассивационных пленках.

Дефекты транзисторов
Для увеличения пропускной способности устройств, снижения энергопотребления и уменьшения форм-фактора, производители микроэлектроники снабдили устройства стеком трехмерным чипов, используя кремниевые транзисторы. Таким образом, они сочетают и кремниевые и компоновочные технологии. В результате, эти новые конструкции обладают высокой надежностью.
Формирование транзисторов, как правило осуществляется в результате процесса глубокого ионного травления. Однако, если при травлении не удалось “просверлить” металл на достаточное расстояние, то транзистор не сможет провести электрический заряд к уровню, лежащему ниже. Изображения 6-11.

Визуализация структуры 45 нм транзистора
Одним из ключевых методов для увеличения длины транзистора несколько последних поколений являлось масштабирование диэлектрического слоя. Данный метод улучшает контроль над электродами, позволяя уменьшить длину каналов и увеличить производительность. С увеличением диэлектрического слоя повышается утечка тока, что обычно приводит к замедлению увеличения диэлектрического слоя из-за возросшего энергопотребление. Для преодоления этих трудностей необходимо было разработать новые диэлектрические стабильные материалы. С уменьшением масштаба возникают трудности в визуализации структур с геометрическими составляющими. Визуализация структуры 45нм транзистора прежде была недоступна компактному СЭМ. Теперь же, с появлением компактного FE-SEM 8500, отображение данных структур впервые стало возможно. (Изображения 12-14).

Контактная площадка BGA
Анализ отказа BGA устройств может быть очень трудным. Основным преимуществом BGA является размещение большого числа контактов входа-выхода (до 500) на сравнительно небольшой площади. Однако, большое количество соединений как раз и делает анализ столь сложной задачей. Двумя из наиболее распространенных видов дефектов являются "дефект черных дорожек" и трещины в прикрепленных кристаллах. "Дефект черных дорожек" связан с остаточным фосфором из химического покрытия металла, вызывающим уменьшение слоя во время пайки припоя. Трещины в прикрепленных кристаллах связаны с несоответствием размеров материалов из-за расширения под воздействием тепла или механического изгиба печатной платы
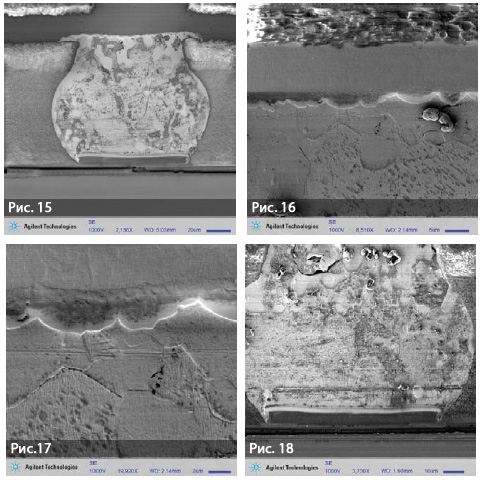
Исследование среза BGA было проведено с помощью СЭМ, чтобы увидеть дефекты, приведшие к отказу устройства (Изображения 15-20). По завершению проверки интерфейса припоя не было найдено никаких доказательств "дефекта черных дорожек" (Изображения 16-18). Однако, удалось найти трещины на прикрепленных кристаллах, видимые при использовании тепловизора (Изображения 19-20).

Заключение
Компактный LV FE-SEM не только легок в использовании, но и обеспечивает передовой метод получения изображений структур полупроводниковых устройств в высоком разрешении без необходимости в покрытии их инертным металлом для уменьшения накопления заряда. Несмотря на то, что исследование полупроводниковых образцов имеет множество сложностей ввиду широкого диапазона материалов, дизайна и обработки, их морфологические особенности и дефекты можно легко исследовать с помощью Agilent 8500 FE-SEM.
